3. Photolithography의 8가지 기본 단계
사실 Photolithography는 Process latitude에 관여되는 수많은 공정 단계가 존재한다.
헌데 이러한 공정을 총 8가지의 단계로 기본적으로 나눌 수 있다.
|
1. Vapor prime (=Wafer prime(웨이퍼 준비)증기 도포) 2. Spin coat (=PR(Photoresist) Coating, 스핀 코팅) 3. Soft bake (가볍게 굽기) 4. Alignment and exposure (정렬과 노출) 5. Post - exposure bake (PEB) (노출 후 굽기) 6. Develop (현상) 7. Hard bake (강한 굽기) 8. Develop inspect (현상 후 점검) |

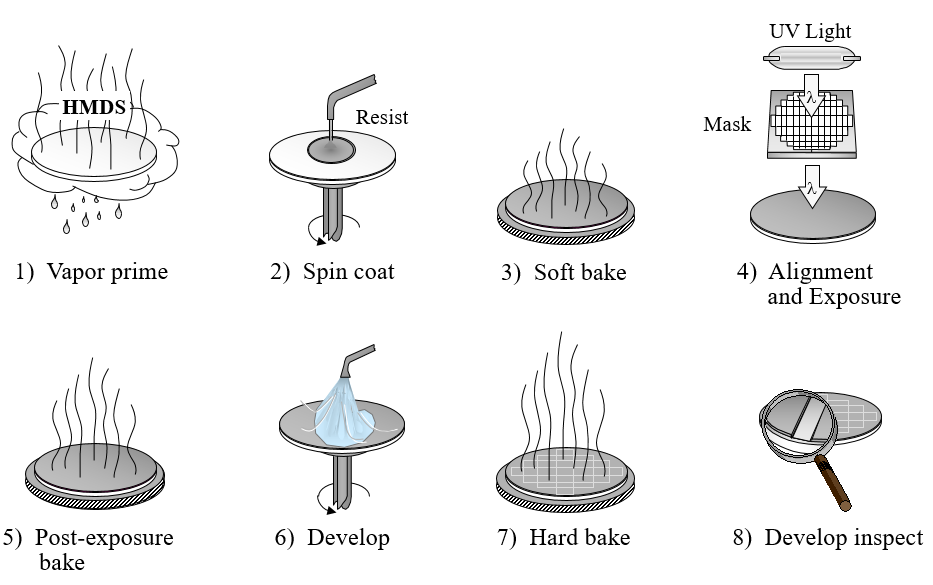
-1) Vapor prime (=Wafer prime, 증기 및 웨이퍼 도포단계) (중요한것: Adhesion)
*prime (뜻: to cover the surface of wood with a special paint before the main paint is put on, https://dictionary.cambridge.org/ko/%EC%82%AC%EC%A0%84/%EC%98%81%EC%96%B4/priming)은 상황에 맞추어 도포라고 하는 것이 맞다.
PRIMING | Cambridge English Dictionary에서의 의미
priming 의미, 정의, priming의 정의: 1. present participle of prime 2. to tell someone something that will prepare them for a particular…. 자세히 알아보기.
dictionary.cambridge.org
Photolithograpy의 첫번째 단계로서 다음 단계에 Photoreist가 잘 달라 붙고 균일하게 도포되도록 전처리하는 과정이다.
그러므로 Clean(세정), Dehydrate(건조) 단계를 거쳐 Wafer 표면이 깨끗하고 건조되도록 보장되어야 한다.
보통 세정을 할 때는 습식 세정을 하며 DI Water(=Deionized Water, 즉 이온이 제거된 상태의 물)도 이용하게 된다.
세정 후에 남은 DI Water의 성분을 날리기 위하여 필수적으로 탈수, 건조, 굽기 과정을 거치게 된다.
(수분증발로 인해 Bubble(거품끼) 제거)
마지막으로 Wafer는 HMDS를 증기화 하여 Wafer에 분사하여 Wafer surface를 Hydrophilic(친수성)에서 Hydrophobicity(소수성)으로 바꿔주는 역할을 한다. (다른방법으로는 N2가스를 이용하여 일정한 압력으로 불어넣어 강제로 HMDS가 막 위에 얇게 퍼지게 할 수도 있다.)
그리고 HMDS 도포 과정을 하면 이후에 올 PR(Photoresist) Coating과정에서 Adhesion(접착력)문제를 해결할 수 있다.
만약 이 과정 잘못되면 뒷 단계인 Spin coat 단계도 잘못되므로 Re-Work(리웍, 재시작)을 해야할 수도 있다.
|
※HMDS(Hexa-Methyl-Di-Silazane, =Adhesion promoter) 도포하는 이유 우리가 알고있는 Wafer는 Hydrophilic(친수성)이다. 그리고 PR(Photoresist)은 유기용매가 물질의 대부분을 차지하므로 기름과 같다생각하면된다(=Hydrophobicity(소수성)) 그런데 HMDS는 계면활성제 같은 것이다. 계면활성제란? 극성(친수성) 부분과 무극성(친유성/소수성) 부분을 동시에 가지고 있어서 물과 기름은 볼래 잘 섞이지 않아서 경계면을 형성하지만, 계면활성제가 들어가면 이 경계면이 활성화되어 섞이게 된다. 그래서 '계면활성제(界面活性劑)'. HMDS이 Si(실리콘)인 wafer(기판)에 붙어버리면 CH3가 Si와 붙어버려 표면은 비극성 상태(소수성)이 된다. 그래서 PR이 Wafer(기판)에 도포도 잘되게 되고 Adhesion이 잘되게 된다.  |
-2) Spin coat (=PR(Photoresist) Coating, 스핀 코팅) (중요한 것: Thickness, Uniformity)
PR(Photoresist)를 Wafer위에 도포하는 단계라고 생각하면된다.
Spin이라는 말대로 회전하는 판인 Spin coat위에 wafer를 올리고 돌린다.
이때 Wafer가 떨어지지말라고 Wafer를 올려두는 기계의 표면에 작은 진공 구멍을 가진 평평한 금속인 Vaccum Chuck(진공 척)위에 Mount(탑재)되어 진공으로 Wafer를 잡고 있어서 떨어질 염려는 하지 않아도 된다. (아래 사진봐)
처음에는 소량의 Photoresist를 dispense(뿌려주다)하여 500rpm(분당 500회전)으로 회전 시킨다.
그리고 마지막으로 쓸모없는 것은 떨어트리기 위해 Ramping up으로 3000 ~ 5000rpm으로 돌려 다 날려버린다.
이때 품질 측정은 Spin 시간, Spin 속도, PR Thickness(두께), PR의 Uniformity(균일도), 공기 중 오염도, 핀이나 홀 같은 PR의 결함도 등으로 측정된다.

-3) Soft bake (가볍게 굽기) (중요한 것: Solvent, Adhesion, Self-rearrangement)
PR 안에는 Solvent(PR을 묽게 해주는 아세트 성분)가 있는데 PR을(를) 더 단단하게 굳혀주기 위해 Solvent를 날리는 공정이다. 이 공정을 지나야만 끈적한 점성이 사라지고 단단해진다 그리고 결론적으로 Adhesion이 좋아지며 PR의 균일성이 증진된다. Solvent성분이 있기에 불이 붙지 않는 온도로 100도정도로 30 ~ 60초간 구워준다. 그렇게하면 95 ~ 98% Solvent(CHO(레진성분)+감광제+계면활성제)성분이 증발하고 밑이 단단하게 달라붙게 된다.
또한 Soft bake를 함으로서 추후 진행되는 etching(식각)공정에서의 linewidth(선폭)의 제어를 용이하게 해준다.??(책에 나왔는데 뭔 소리지... 그냥 굳혀줘서 좋다는 거겠지?)
마지막으로 구워진 Wafer는 Cooling 단계에 들어가 온도를 낮춰서 resist의 특성을 Uniformity하게 가지도록 해준다.
-4) Alignment and exposure (정렬과 노출) (중요한 것: Light source, Align key)
PR이(가) 도포된 Wafer 위에 Pattern을 찍어야되는데 그 Pattern은 Mask가 가지고 있다. 그러므로 Mask를 잘 조절해야된다. 조절 후 UV light source(빛, EUV, DUV 등)를 쪼아주는데 빛을 쪼아주는 이유는 PR의 광민감 성분을 활성화 하려고 해서 그렇다.맞출때 평면 X, Y축 뿐만아니라 Rotation, Height 등 맞출 것이 많다. 그리고 이 단계에서 노광을 진행한다.
또한 맞출때 Align key를 사용하는데 이때 Align key는 같은 layer상에서 가장 작게 Pattern된 것보다 더 작게 하여 pattern들이 잘 맞춰지도록 오차범위를 줄여야 된다.
이때 품질 측정은 Linewidth resolution(선폭 해상도), Overlay accuracy(겹침의 정확성), Particles(입자), defects(결함)을 확인하여 측정하게 된다.

-5) Post - exposure bake (PEB) (노출 후 굽기) (중요한 것: Resolution, Heat uniformity)
예전에는 잘 안했는데 요즘은 Standard하게 존재하는 공정이다. 남은 Solvent를 더 날리는 공정이다.
-6) Develop (현상) (중요한 것: Chemical reation)
현상단계로서 PR을 모두 벗겨내는 과정이다. 이렇게 함으로 결국 PR에 Pattern만 남게 되어 중요한 단계이다. 오래하면 안좋다.(이유: 그냥 모든게 다 현상되버린다....) 현상방법은 보통 Spin(회전), Spray(분사), Puddle(휘젓기)가 있고 현상 이후에 바로 DI Water 용액으로 헹구고 회전시켜서 건조시켜준다.
이때 품질 측정은 현상 후 PR에 남겨진 Pattern의 Linewidth resolution(선폭 해상도), 표면의 전반적인 Uniformity(균일성), Particles(입자), defects(결함)을 확인하여 측정하게 된다.

-7) Hard bake (강한 굽기) (중요한 것: Heat uniformity)
Positive resist기준으로 120 ~ 140도의 온도에서 모든 것을 굳히는 단계이다. 이때 Adhesion이 개선되며 잔류 PR 용매를 증발시켜버린다. 이 공정은 후에 올 Etch와 Ion-implant공정을 위해서 Resist를 안정화 시키는 중요한 공정이다. 온도가 너무 높게 되면 resist를 흘러가게 하고 Pattern에 변형을 유발시키기 때문에 정확한 온도를 유지하여야한다.
-8) Develop inspect (현상 후 점검) (중요한 것: Microscope)
최종 점검하는 단계이다.
점검이 Defects(결함)이 있는 것들은 Re-work를 돌릴 수 있다. 허나 이때 Defects를 발견하지 못하고 다음 공정인 Etching, Ion-implant 등으로 넘어가게 되면 영영 정정할 기회를 잃어버리게 된다.
※참고자료: Michael Quirk & Julian Serda, Semiconductor Manufacturing Technology, PEARSON 2001
※참고및 인용 자료: 나무위키(Photolithography), OLYMPUS, WIKIPEDIA, SKhynix NEWSROOM, CambridgeDictionary
※Copyright 2011 Prentice Hall. All rights reserved.
※본 게시물 속 내용을 통해 직접적으로 상업적인 목적이 없으며 게시물은 개인 공부 목적 및 지식 간단 연구목적으로 사용되었음을 명시함. 책 및 인터넷 검색을 참고자료로 하여 실습 및 학습을 한 내용을 올림. 참고한 책 및 인터넷 검색물의 저작권을 존중하므로 책 및 인터넷 저작물의 일부 또는 전부를 무단 복제 및 무단 전재 및 재배포하지 않음(일부라 함은 30%이하의 내용 중복은 불포함[30%이하는 다른 저작물로 간주]). 또한 책 또는 매체를 구매하지 않고는 정확한 내용을 알 수 없으며 개인이 따로 공부한 내용도 추가 되어 책과는 내용이 매우 상이할 수 있음.즉 본 게시물 작성자는 이 게시물을 읽는 모든 사람들이 책을 구매거나 인터넷 검색을 더하여 지식을 같이 나누었으면 좋겠음.
※저작권법 제 28조: 공표된 저작물은 보도, 비평, 교육, 연구 등을 위하여는 정당한 범위 안에서 공정한 관행에 합치되게 이를 이용할 수 있다.
※저작권법에 의거 본 게시물은 원저작물에 대한 수요를 대체하지 아니하며 일반적인 관념, 수록형태를 모두 준수함.
'Semiconductor Manufacturing Tech > Photolithography' 카테고리의 다른 글
| [Photolithography (3.2)/S.M.T.] Spin Coat (스핀코팅)/ PR Coating (0) | 2020.03.27 |
|---|---|
| [Photolithography (3.1)/S.M.T.] Wafer Prime / Vapor Prime (0) | 2020.03.27 |
| [Photolithography (2)/S.M.T.] Positive / Negative Lithography (0) | 2020.03.27 |
| [Photolithography (1) /S.M.T.] 포토리소그래피 용어 정리 (0) | 2020.03.26 |



